【导读】2025年,三星电子在半导体技术领域抛出一枚重磅信号:其系统封装实验室副总裁Kim Dae-Woo在近期产业研讨会上透露,当前主流的热压缩键合(TCB)技术已难以支撑20层(16层以上)HBM内存堆栈的生产需求,这一瓶颈或将推动下一代键合技术的加速落地。
2025年,三星电子在半导体技术领域抛出一枚重磅信号:其系统封装实验室副总裁Kim Dae-Woo在近期产业研讨会上透露,当前主流的热压缩键合(TCB)技术已难以支撑20层(16层以上)HBM内存堆栈的生产需求,这一瓶颈或将推动下一代键合技术的加速落地。
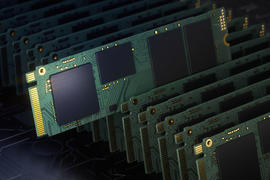
键合工艺:HBM制造的核心痛点
作为HBM(高带宽内存)制造的核心环节,键合工艺负责连接各层DRAM芯片,其技术演进直接影响堆叠层数、信号传输效率及散热性能。传统TCB技术依赖凸块结构实现层间连接,但凸块的存在限制了间距进一步压缩,同时导致热阻较高,成为制约HBM向更高层数发展的关键阻碍。
混合键合(HCB)技术:突破层数与热阻的利器
三星电子提供的对比数据显示,采用无凸块设计的混合键合(HCB)技术可将HBM堆叠层数提升最多1/3,同时热阻降低至多20%,为突破当前技术瓶颈提供可行路径。相较于TCB,HCB通过直接金属-金属接触实现更精密的层间连接,显著优化了电气性能与散热效率。
技术转型节点:HBM4E与HBM5的关键分界
据三星规划,16层堆叠将成为HBM键合技术从TCB向HCB转型的关键节点,这一节点大致对应HBM4E内存世代。而到HBM5时代,混合键合技术有望实现全面应用,推动HBM内存向更高带宽、更低功耗方向演进。
结语
三星此次技术表态,不仅揭示了HBM内存向20层以上堆叠发展的技术挑战,更明确了混合键合技术作为下一代解决方案的核心地位。随着HBM4E及HBM5的逐步落地,键合工艺的革新或将重新定义高端内存市场的竞争格局。
推荐阅读:
苹果iPad Pro 2025款重磅升级:M5芯片+双镜头,供应链厂商迎增长契机






