【导读】随着AI算力需求爆发,先进封装技术迎来关键转折——CoWoP(无基板封装)正成为继CoWoS之后的新焦点。英伟达考虑将其用于下一代Rubin GPU,引发产业链震动。这一技术若落地,将重塑芯片制造格局,并带动PCB、材料等上下游企业迎来新机遇。
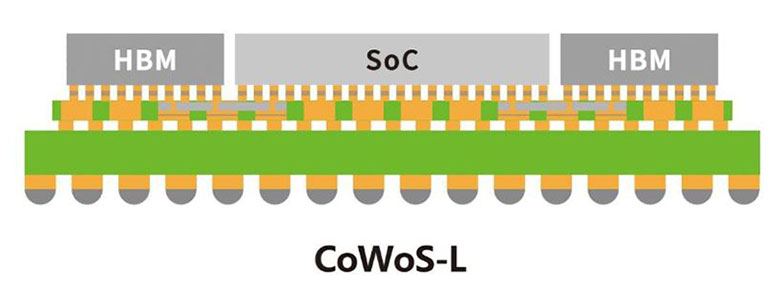
1. CoWoS的瓶颈:成本与性能的双重挑战
台积电主导的CoWoS技术虽解决了AI芯片的"内存墙"问题,但依赖硅中介层和ABF基板,导致成本高企(基板占40%-50%成本)且信号损耗显著。尽管台积电计划2025年将月产能提升至8万片,仍难满足市场需求,倒逼行业探索替代方案。
2. CoPoS与CoWoP:下一代封装的技术竞速
-
CoPoS:采用方形面板替代晶圆,可集成10-12颗HBM4,带宽达19TB/s,单位成本更低,预计2028年量产。
-
CoWoP:革命性取消ABF基板,直接将芯片键合至PCB,缩短信号路径、提升散热效率,但面临PCB良率与返修率的技术瓶颈,乐观预测2028年量产。
3. 产业链受益者:PCB与材料厂商站上风口
若CoWoP落地,胜宏科技(40层PCB量产)、深南电路(通信PCB龙头)、鹏鼎控股(AI服务器布局)等PCB企业将直接受益。材料端,宏和科技(低介电电子布)和方邦股份(可剥离铜箔)已通过英伟达认证,成为关键技术供应商。
4. 技术争议:现实障碍与巨头博弈
大摩等机构认为,CoWoP短期内难大规模应用:
-
PCB线宽精度(25微米)仍落后于ABF基板(10微米以下);
-
供应链重组风险高,英伟达Rubin GPU或优先采用成熟方案。
5. 企业动态:扩产与资本布局加速
-
胜宏科技计划量产78层PCB,并筹划港股上市融资10亿美元;
-
深南电路推进泰国工厂建设,拓展全球化产能;
-
鹏鼎控股聚焦AI PC/服务器,加码新材料研发。
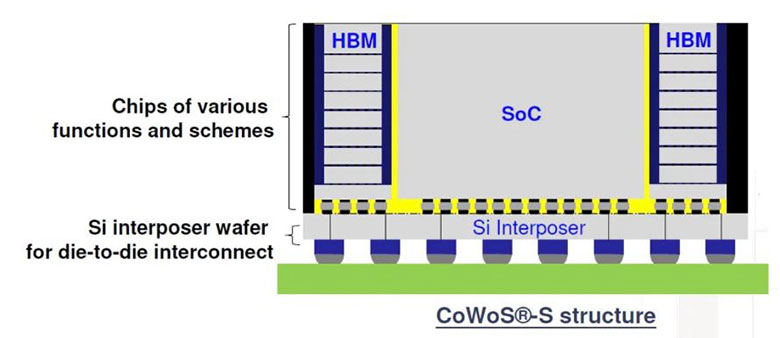
结语:
CoWoP代表了先进封装向低成本、高性能迈进的尝试,但技术成熟度与产业链协同仍是关键挑战。未来3-5年,CoWoS与CoPoS将主导市场,而CoWoP能否逆袭,取决于PCB技术的突破与巨头们的战略选择。这场技术竞赛,或将决定AI芯片的下一代制造标准。
推荐阅读:
月产200万颗只是起点!群创FOPLP技术或成AI算力新引擎
DDR4供应告急:全球厂商转向DDR5/HBM,DRAM价格飙升
SIA:2025年6月全球半导体销售额同比增19.6%,亚太美洲领涨
3nm制程+Travis超大核!天玑9500能效升级或成2025年安卓旗舰首选






