【导读】群创光电董事长洪进扬在最新法说会上宣布,公司扇出型面板级封装(FOPLP)技术已进入规模化量产阶段。其中,采用Chip-First工艺的产品自上季度开始出货,当前月产能已稳定达到200万颗,技术迭代与市场需求同步加速,为半导体封装领域注入新动能。
群创光电董事长洪进扬在最新法说会上宣布,公司扇出型面板级封装(FOPLP)技术已进入规模化量产阶段。其中,采用Chip-First工艺的产品自上季度开始出货,当前月产能已稳定达到200万颗,技术迭代与市场需求同步加速,为半导体封装领域注入新动能。
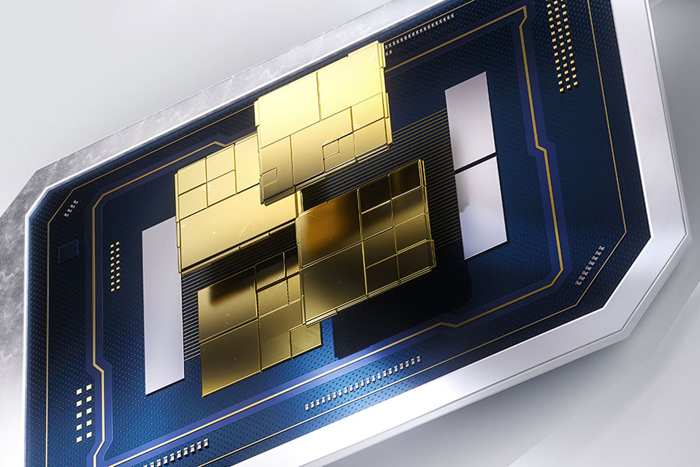
技术突破与产能规划
洪进扬透露,FOPLP技术体系覆盖从工艺转型(如Chip-First向Chip-Last升级)到前沿领域(RDL集成、TGV开发)的多维度创新。当前量产的Chip-First方案线宽达10微米,技术成熟度高,尤其适用于高压、高频芯片的封装需求。2025年第二季度,该技术月出货量突破200万颗,预计年底将因客户需求激增跃升至数千万颗规模。
经济效益与战略布局
据测算,此轮FOPLP订单总营收有望达数十亿元新台币,利润贡献将从2025年第四季度起逐步释放。随着产能爬坡,2025年下半年至2026年第一季度,FOPLP业务对集团营收的拉动效应将更为显著,其毛利率预计将超越公司现有平均水平。
技术优势与行业影响
FOPLP的核心竞争力源于面板级制造的规模优势。通过采用方形基板替代传统圆形晶圆,单位面积芯片排布量大幅提升,基板利用率高达95%。以3.5代线FOPLP玻璃基板为例,其有效封装面积是12英寸晶圆的7倍,显著降低单颗芯片成本。这一特性与AI算力芯片对高性能、低成本封装的需求高度契合,成为群创技术布局的核心方向。
结语
在半导体封装向高端化演进的背景下,群创凭借FOPLP技术的量产突破与成本优势,不仅巩固了自身在先进封装领域的地位,更为AI、高压器件等下游应用提供了高效解决方案。随着产能持续释放与技术深化,FOPLP有望成为驱动2025年半导体产业升级的关键力量。
推荐阅读:
DDR4供应告急:全球厂商转向DDR5/HBM,DRAM价格飙升
SIA:2025年6月全球半导体销售额同比增19.6%,亚太美洲领涨





