【导读】芯片需求的激增正在影响IC封装供应链,造成精选制造能力、各种封装类型、关键部件和设备的短缺。封装方面的现货短缺在2020年底浮出水面,此后蔓延到其他行业。目前,供应链上出现了各种卡口。线束和倒装芯片的产能在整个2021年都将保持紧张,还有一些不同的封装类型。此外,IC封装中使用的关键元件,即引线框架和基板,也是供不应求。最近台湾一家封装基板厂发生的火灾使问题更加严重。除此之外,贴片机和其他设备的交货周期也在延长。
一般来说,封装方面的动态反映了半导体业务的整体需求状况。从2020年中期开始,服务器和笔记本市场获得了动力,为这些市场创造了对不同芯片和封装的巨大需求。此外,汽车行业的突然回暖使市场发生了翻天覆地的变化,造成了芯片和代工产能的普遍短缺。
半导体和封装市场的短缺并不新鲜,在IC产业的需求驱动周期中也会出现。不同的是,业界终于开始认识到封装的重要性。但封装供应链某些环节的脆弱性,尤其是基板,让许多人措手不及。
供应链的限制已经造成了一些出货延迟,但目前还不清楚这些问题是否会持续下去。毋庸置疑,包装供应链亟待加固。首先,封装在整个行业中发挥着更大的作用。OEM厂商希望芯片更小、更快,这就需要新的、更好的、具有良好电气性能的IC封装。
同时,先进的封装正在成为开发新的系统级芯片设计的一个更可行的选择。芯片扩展的功率和性能优势在每一个新的节点上都在减少,而自finFET推出以来,每个晶体管的成本一直在上升。因此,虽然扩展仍是新设计的一种选择,但业界正在寻找替代方案,而将多个异构芯片放在一个先进的封装中就是一种解决方案。
"人们已经意识到封装的重要性,"TechSearch International总裁Jan Vardaman说。"它已经提升到公司和半导体公司的企业层面的讨论。但我们的行业正处于这样一个关口,如果我们的供应链不处于良好的状态,我们根本无法满足需求。"
为了帮助业界在市场上获得一些启示,《半导体工程》对目前封装以及供应链的动态进行了分析,包括产能、封装和组件。
芯片/封装热潮
这是半导体行业的一次过山车之旅。在2020年初,业务看起来很光明,但在Covid-19大流行病爆发的情况下,IC市场下跌。
在整个2020年,不同的国家实施了一系列措施来缓解疫情,如留守订单和企业关闭。经济动荡和工作岗位的流失很快就出现了。
但到了2020年中期,由于留守经济带动了电脑、平板电脑和电视的需求,IC市场反弹。根据VLSI Research的数据,2020年,IC行业高调收官,芯片销量比2019年增长了8%。
这种势头已经延续到了2021年的前半段。根据VLSI Research的数据,2021年半导体市场总共预计将增长11%。
"我们看到了巨大的需求,由于物联网、边缘设备和5G实现的智能设备,"ASE首席运营官Tien Wu在最近的电话会议上表示。"随着高性能计算、云计算、电子商务,以及5G的低延迟和高数据速率,我们看到了更多的智能设备、电动汽车以及所有物联网应用。"
去年,汽车市场萎靡不振。最近,汽车公司的需求重新恢复,但他们现在面临着一波芯片短缺。在某些情况下,汽车制造商被迫暂时关闭部分工厂。
拥有晶圆厂的IC厂商以及代工厂无法满足汽车和其他市场的需求。"在2020年日历的大部分时间里,晶圆厂以非常高的利用率运行--无论是200mm还是300mm晶圆厂--几乎所有技术都是如此,"联电业务发展副总裁Walter Ng表示。"汽车领域绝不是被单独挑出来的,因为所有领域和应用似乎都在供应紧张的情况下运行。去年下半年确实有许多汽车厂因COVID而停工。我们观察到许多汽车半导体供应商在这些时期减少或停止订货。如果你考虑到这一点,再加上汽车行业的精简库存做法,这些可能是导致我们今天看到的汽车特定短缺的因素。"
有一些警告信号。"我们看到汽车半导体供应商的需求在20年第二季度初左右开始波动。直到20年第4季度初左右,我们才看到汽车半导体供应商的需求开始恢复到更典型的需求水平。"Ng说。"作为一个总的趋势,我们看到汽车电子领域有不错的增长,它涵盖了从0.35微米分立MOSFET器件到28纳米/22纳米ADAS产品以及介于两者之间的所有工艺技术,如车身和底盘控制、信息娱乐和WiFi。我们预计,在可预见的未来,汽车用半导体含量将继续增长。"
所有这些市场都刺激了对封装容量和封装类型的需求。量化产能的一种方法是看工厂利用率。
全球最大的OSAT公司ASE,其整体工厂利用率从2020年第一季度的75%提高到80%,到去年第二季度达到85%左右。到了第三季度和第四季度,ASE的包装利用率远远超过80%。
在2021年上半年,包装产能的整体需求仍然强劲,在一些细分市场看到供应紧张。"我们看到产能几乎全面紧张,"Amkor线束BGA产品副总裁Prasad Dhond说。"除汽车外,大多数终端市场在整个2020年都保持强劲。在2021年,我们继续看到这些市场的强势,汽车也已经复苏。因此,汽车市场的回暖肯定会增加产能的限制。"
其他方面,包括在岸包装厂商,也看到了需求的增加。"美国本土包装产能似乎保持稳定,"Quik-Pak销售和营销副总裁Rosie Medina说。"每个人都在尽其所能管理增加的需求。"
线框、引线框架短缺
市场上存在多种不同的IC封装类型,每种类型针对不同的应用。
一种细分封装市场的方法是按互连类型划分,其中包括线键、倒装芯片、晶圆级封装(WLP)和通硅孔(TSV)。互连器件用于将一个芯片与另一个封装中的芯片连接起来。TSV的I/O数量最多,其次是WLP、倒装芯片和wirebond。
根据TechSearch的数据,目前大约75%到80%的封装是基于线键的。早在20世纪50年代就开发出来的wire bonder,是用细小的导线将一个芯片缝合到另一个芯片或基板上。线材键合主要被用于低成本的传统封装、中端封装和内存裸片堆叠。
2020年上半年,线键产能需求低迷,但2020年第三季度需求激增,导致线键产能趋紧。ASE当时表示,至少在2021年下半年之前,线束产能都将保持紧张。
线束市场还出现了其他趋势。"我们所做的堆叠模具数量比以前更多,"ASE的Wu在2020年第三季度的电话会议上说。"所以在这个特殊的周期中,不仅仅是数量。还包括模具数量、线材数量以及复杂性。"
到目前为止,在2021年,由于汽车和其他市场的繁荣,线束产能受到限制。采购足够的线束机来满足需求也变得越来越困难。
"产能仍然紧张,"ASE的Wu在最近的电话会议上说。"上次我做了一个评论,线棒短缺至少会到今年第二季度。现在,我们稍微调整了我们的观点。我们认为,线型债短缺将贯穿2021年全年。"
在2020年初,采购线棒相对容易。随着2020年下半年需求的回升,线束机刀具交货期延长至6至8个月。"现在,机床交货周期更像是6到9个月。"Wu说。
贴线机用于制造多种封装类型,如四平无引线(QFN)、四平封装(QFP)等。
QFN和QFP属于封装类型中的引线框架组。引线框架是这些封装的关键部件,基本上是一个金属框架。在生产过程中,模具被连接到框架上。引线通过细线连接到芯片上。

图1.QFN封装。
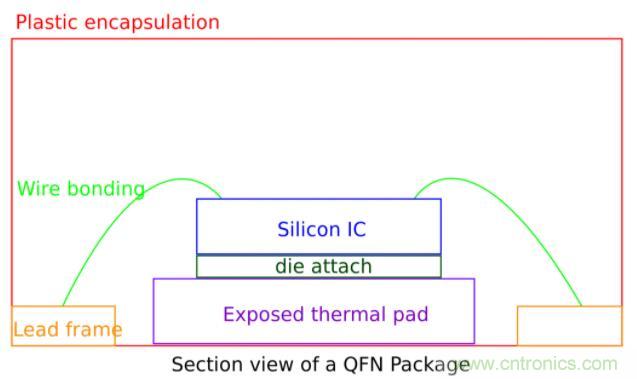
图2.QFN侧视图。
"通常情况下,QFN是线接的,尽管你也可以设计成倒装芯片,"Quik-Pak的Medina说。"虽然倒装芯片QFN可以比线接QFN更小的尺寸/脚印,但它们的制造成本更高一些,因为需要凸起的模具。很多客户会选择QFN,因为其尺寸小,性价比高。传统的包覆式QFN格式是许多应用的经济选择。当标准JEDEC尺寸不适用时,定制尺寸也可以被认为是经济的,例如我们的开模塑料封装(OmPP)。这些有各种JEDEC格式和定制配置。"
引线框封装用于模拟、射频和其他市场的芯片。"我们看到对QFN封装的需求比以往任何时候都要强烈,"Medina说。"它们被用于许多终端市场,如医疗、商业和mil/aero。手持设备、可穿戴设备和带有许多组件的电路板都是主要应用。"
不过在景气周期中,面临的挑战是如何从第三方供应商那里获得充足的引线框架供应。引线架业务是一个低利润的领域,经历了一波整合。一些供应商已经退出了该业务。
如今,QFN封装需求旺盛,这就产生了对更多引线框架的需求。虽然一些包装厂能够获得足够的引线框架,但其他包装厂却出现了短缺。
"引线框架供应紧张,"Amkor的Dhond说。"供应商的产能无法跟上需求。贵金属价格上涨也在影响铅框价格。"
先进封装、基材困境
许多先进封装类型的需求也很旺盛,特别是倒装球栅阵列(BGA)和倒装芯片级封装(CSP)。2.5D/3D、扇出和系统级封装(SiP)的产量也在增加。
倒装芯片是一种用于开发BGA和其他封装的工艺。在倒装芯片工艺中,铜凸块或支柱形成在芯片之上。器件被翻转并安装在一个单独的芯片或电路板上。凸点落在铜垫上,形成电气连接。

图3:倒装芯片安装的侧视图。
根据Yole Développement的数据,在汽车、计算、笔记本等产品的推动下,倒装芯片BGA封装市场预计将从2020年的100亿美元增长到2025年的120亿美元。
"倒装芯片产品的整体产能在2021年将继续以高利用率运行,设备交货期将推到大于我们通常经历的2倍,"Amkor高级副总裁Roger St.Amand说。"根据现有的预测,我们预计这一趋势将持续到2021年,并进入2022年,这是由通信、计算和汽车市场领域的更高需求所推动的。总的来说,我们在所有倒装芯片封装技术中都看到了这种趋势。"
同时,扇出式和扇入式封装是基于一种名为WLP的技术。在扇出的一个例子中,一个存储器裸片被堆叠在一个封装的逻辑芯片上。扇入式,有时称为CSP,用于电源管理IC和射频芯片。根据Yole的数据,WLP市场总共预计将从2019年的33亿美元增长到2025年的55亿美元。
2.5D/3D封装用于高端服务器和其他产品。在2.5D中,模具被堆叠或并排放置在中间体之上,中间体包含TSV。
同时,SiP是一种定制的封装,它由一个功能性电子子系统组成。"我们看到各种新的SiP项目,涵盖了光学、音频和硅光子学,以及很多智能手机边缘设备,"ASE的Wu说。
这些先进的封装类型中,很多都使用了层压基板,而层压基板是供不应求的。其他封装则不需要基板。这取决于应用。
基板在封装中作为基础,它将芯片与系统中的电路板连接起来。基板由多层组成,每一层都包含金属线和通孔。这些路由层提供了从芯片到电路板的电气连接。
层压基板是双面或多层产品。有些封装有两个双面层,而更复杂的产品有18至20层。层压基板基于各种材料组,如味之素(ABF)建立材料和BT树脂。
一般来说,在供应链上,包装厂从各种第三方供应商那里购买基材,如Ibiden、Kinsus、Shinko、Unimicron等。
去年,当对层压基板的需求激增时,问题开始浮出水面,导致这些产品的供应紧张。去年年底,台湾尤尼姆龙公司旗下的一家生产工厂发生火灾,问题升级。Unimicron将生产转移到其他工厂,但一些客户仍无法获得足够的基板以满足需求。
最近几周,Unimicron同一工厂又发生了一起火灾,当时工人们正在清理工厂。不过当时该工厂并没有在生产。
持续的需求,再加上供应链上的各种阻碍,使得2021年的基板形势大为恶化。在某些情况下,随着交货期的延长,基板的价格也在上涨。
"与我们在设备方面所经历的情况类似,我们看到倒装芯片基板的交货时间也有相当大的增长,"Amkor的St.Amand说。"在某些情况下,衬底交付时间增加到超过行业内通常的4倍。这一趋势主要是由计算领域对大体量和高层数单片ABF基板的持续较高需求所驱动。此外,我们还看到汽车行业的强劲复苏,在某些情况下,这与上述高端计算机基板的需求直接竞争。我们还看到,在通信、消费和汽车领域,对用于车身较小的产品的带状PPG基板的需求也在增加。"
与此同时,业界正在研究解决这一问题的方案,但这些方法可能会有欠缺。"我认为,IC封装基板的商业模式基本上已经被打破了,"TechSearch的Vardaman说。"我们需要有某种新的方法来处理这些商业关系,以保证供应。我们在价格上几乎把这些可怜的基板供应商打得落花流水。他们已经无法维持他们的利润率。这不是一个健康的局面。"
这里没有快速解决的办法。基板供应商可以简单地提高产品价格以提高利润率,但这并不能解决产能问题。
另一个可能的解决方案是基板供应商建立更多的制造能力以满足需求。但一条大规模的先进衬底生产线的成本约为3亿美元。
"如果这些基板公司认为产能在两三年内不会被利用,那么所需的投资水平就不会让他们感到舒服。"Vardaman说。"他们需要获得投资回报,如果他们认为需求会减少,那就很难做到。而当他们投资了太多的产能,然后价格下跌,会发生什么?他们无法获得回报,利润率也会受到影响。所以这是一个非常艰难的局面。我想说的是,我们这个行业的情况真的很糟糕,因为这个原因。"
一个成本较低的选择是简单地提高现有基板生产线的良率,从而实现更多可用产品。但供应商需要在新的昂贵的计量设备上投入更多。
包装厂也在寻找不同的解决方案。最明显的一种是向不同的供应商采购基材。但据Vardaman介绍,要想获得一个新的基材供应商的资格,需要25周或25万美元。
另外,封装厂可以开发和销售更多的无基板IC封装。但许多系统需要带有基板的封装,在某些情况下,这种封装更加坚固可靠。
情况并非毫无希望。封装厂需要与供应商更紧密地合作。"我们正在与客户合作,以获得更长期的预测来订购材料,"Amkor的Dhond说。"我们正在限定第二来源,以保证适当的供应。"
这也创造了一些新的机会。Quik-Pak公司去年推出了一项基板设计、制造和组装服务。通过这项服务,该公司支持各种类型的封装基板。"我们肯定看到了对我们的基板开发服务的需求增加,通过这种服务,我们为基于基板的组装创造交钥匙解决方案,以适应客户的包装要求,"Quik-Pak的Medina说。"我们能够将客户的要求集中在一起,并利用价格和交货期来选择合适的晶圆厂合作伙伴,这对于将基板的供应保持在合理的交货期内至关重要。美国本土供应商可以将交货期缩短50%以上。"
显然,对包装的需求已经急剧上升,但行业必须加强供应链。否则,包装厂商将面临更多的延误,甚至失去机会。不利的一面是,所有这些都需要更多的投资,为了达到一定的规模,可能需要对某些细分领域的厂商基础进行整合。但这也为新的和更多的创新方法打开了大门,这对实现这一目标至关重要。
免责声明:本文为转载文章,转载此文目的在于传递更多信息,版权归原作者所有。本文所用视频、图片、文字如涉及作品版权问题,请联系小编进行处理。
推荐阅读:




