【导读】正在推进“吸引未来”技术开发工作的TDK以全新理念开发了柔性超薄型薄膜电容器(TFCP)作为克服MLCC(积层贴片陶瓷片式电容器)薄型化极限的解决方案。这款超薄型薄膜电容器(TFCP)是作为基板内置用片状电容器开发的产品,其厚度在50μm以下。

在对空间节省提出极致要求的电子设备中,近年来对于有效运用LSI封装基板内部(厚度)的趋势不断增长。TDK的超薄型薄膜电容器(TFCP)是作为基板内置用片状电容器开发的产品,主要为了削减用于去耦而大量搭载的MLCC的搭载空间。其厚度在50μm以下,通过内置于LSI正下方封装基板内部,能够在高频范围内得到极其优异的去耦效果。尤其对于数据中心服务器等追求更高频率、更高速度的高端设备,其最适合在其中发挥去耦电容器的作用。同时,因为其轻薄、柔性特点,不仅在智能手机等移动设备中,还有望运用于穿戴式设备及IoT设备等。
TDK超薄型薄膜电容器(TFCP)的特点
● 在镍箔中形成电介质薄膜,并叠加薄层铜电极的片状电容器
● 过采用高结晶化钛酸钡类电介质实现高介电常数(相对介电常数:~1000)
● 超薄型(厚度50μm以下)、柔性特点使其可在任何形状状态下使用
● 在增层基板的转接板内实现多个电容器集中内置
● 通过电极图案设计,可实现任意静电容量
● 帮助数据中心服务器等高端设备进一步实现高频率化、高速化、省电化
主要用途
● 基板内置用电容器
● 高速LSI的去耦
产品背景
不断细化的半导体制造工艺推动了微处理器、存储器、FPGA以及系统LSI等数码LSI的高速化与高频率化发展,并为ICT社会的发展起到了牵引作用。而另一方面,随着LSI驱动电压不断降低,供应的电源电压对PI(Power Integrity:电源完整性)提出了越来越高的要求。这是因为,电源线的电压变动会使电路产生不稳定,从而可能引起错误工作或增大噪音。
为了应对这种情况,电源线与底板连接了多个电容器(图1)。即使流过LSI的电流量发生急剧变化,电容器中存储的电荷可起到抑制电压变动的作用,同时,还会将引起噪音的交流成分旁通至底板侧。这称为“去耦”。也就是说,通过将可从LSI侧观察到的电源线与底板间的阻抗抑制到尽可能小的数值来提高PI。

图1:电源线的去耦电容器
电容器交流通过容易度取决于交流频率与电容器静电容量。频率越高且静电容量越大时越容易通过。但电容器带有导线或电极等拥有的电路图中所不会出现的电感器成分或电阻成分。这称为ESL(等效串联电感)、ESR(等效串联电阻)。
去耦过程中,为了在较大的频率范围内衰减交流成分,通常会配合并联多个电容器。低频率交流成分旁通中会使用电解电容器等大容量电容器,但为了在高频率范围中降低阻抗,需要ESL、ESR较小的电容器。为此在高频率范围去耦中大多使用MLCC(积层贴片陶瓷片式电容器)。这是因为MLCC的ESL、ESR较小,阻抗-频率特性优异。
搭载于LSI周围,用于去耦的MLCC数量有时会达到数10个~100个左右。而另一方面,随着LSI封装不断小型、薄型化,可用于搭载MLCC的空间越来越少。此外,去耦电容器原则上应在LSI电源端子附近,且应以尽可能短的距离连接底板。若对配线线路进行分支或延长,则阻抗会因为配线的ESL或ESR而变高,从而导致去耦效果降低。
为此,如何有效运用贴装LSI的基板内部成为了解决此类问题的有力解决方案之一。例如,以往便使用有在基板内部开设空腔(cavity)并嵌入薄型MLCC的方法。然而通过积层工艺制造的MLCC,其厚度在0.1mm左右便达到了极限。同时,要在基板内内置多个MLCC还存在技术性难题,因此并非上策。TDK全新开发了厚度在50μm以下的柔性基板内置用超薄型薄膜电容器(TFTP)。如图2所示,此电容器取代配置于LSI周围MLCC,是在LSI正下方基板内部且在与LSI最短距离进行内置,或可嵌入基板内部裸片正下方的片状电容器。
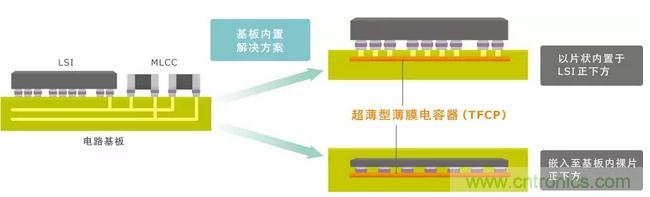
图2:从表面贴装MLCC转变到片材类超薄型薄膜电容器(TFCP)的基板内置解决方案
最适合用于通过TDK材料技术与薄膜技术实现的基板内置结构中的超薄型薄膜电容器(TFCP)
TDK的超薄型薄膜电容器(TFCP)是将电介质薄膜夹在2张薄金属之间的结构(图3)。其在作为下部电极的高纯度镍(Ni)箔上以溅射法形成钛酸钡类电介质薄膜后,将作为上部电极的铜成型为薄膜进行制造。

图3:TDK超薄型薄膜电容器(TFCP)的结构

TDK在溅射等制造装置也实现了自己生产,通过形成几乎没有针孔或开裂等的优质电介质膜,确立了以极高的良率量产片状超薄型薄膜电容器的技术。其拥有整体厚度在50μm以下的超薄体型以及柔性特点,即使卷绕在铅笔粗细的物体上也不会产生缺陷。
同时,每1cm2的静电容量为1μF,实现了打破以往常识的高静电容量。之所以能够实现这一静电容量,是因为通过钛酸钡类电介质的材料设计、优化以及溅射后的退火(热处理),加快了电介质薄膜的高结晶化,实现了比以往产品高出10倍的相对介电常数(~1000)。
本报道中以LSI的去耦用途为中心,介绍封装基板中的片状积层工艺。
转接板基板中集中内置多个电容器
封装技术及贴装技术为半导体设备的高集成化做出了巨大贡献。半导体封装可保护芯片免受外部环境影响,同时还发挥着与打印配线版进行电气连接的重要作用。得到广泛使用的FC(倒装芯片)-BGA(球栅阵列)基板等,在LSI中,使用了增层基板的转接板在LSI与打印配线版之间起到中间作用,作为封装进行使用。
增层基板是通过在作为磁芯层的积层基板上下层中通过激光等方式开孔后形成过孔,然后通过镀层方式使各层间形成电气连接,同时一层一层进行叠加的工艺进行制造(无磁芯的薄型产品也有)。
增层基板的转接板厚度一般在1~2mm左右,增层层间仅为100μm左右,但近年来,有效运用转接板基板内部的技术也越来越受到关注。原本增层基板是将半导体制造技术运用到封装基板中的产品,与打印配线版(PCB等)相比,其可以极高精度进行制造。TDK的电容器(TFCP)是为了满足这一需求而通过全新理念开发的产品。
图2中介绍的片状超薄型薄膜电容器照片是作为内置电容器诞生前的产品外观,在将其内置到转接板内时,将会在转接板制造过程中对基板进行积层加工,其中诞生了多个内置电容器。该流程如下图4所示。

图4:将超薄型薄膜电容器(TFCP)内置于转接板基板中的流程示例
首先,将超薄型薄膜电容器(TFCP)的片材切割成为规定的尺寸及形状后,通过光刻对作为下部电极的镍层进行图案加工。其次,将绝缘层夹于中间,以积层方式加工成为基板后,对作为上部电极的铜层进行图案加工。
以下介绍普通增层工艺。通过激光等在绝缘层上开过孔,并通过镀层使层间形成电气连接,同时通过光刻形成配线图案。图案加工中可使用从铜箔中除去多余图案的移除法以及在绝缘层上添加铜图案的添加法。增层基板中两种方法均有使用。通过反复进行这一工序,可在基板内部内置多个电容器,从而形成立体型配线线路。
如图5所示,超薄型薄膜电容器形成于LSI正下方电源板与底板之间。静电容量可通过电极图案进行自由设计,其最大的优势在于可形成多个电容器后进行集中内置。通过巧妙配合增层工艺对独特片状结构超薄型薄膜电容器进行内置的全新构思,实现了在LSI正下方的转接板基板内,以与LSI之间的最短距离进行配置。为此,其能够在实现超高效去耦的同时,使封装基板节省大量空间。
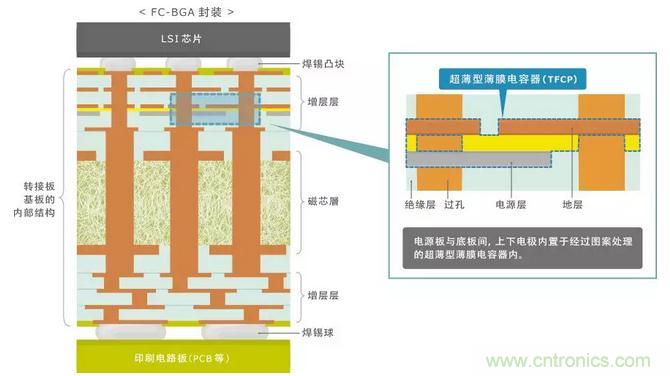
图5:转接板基板结构与内置超薄型薄膜电容器(TFCP)的示意图
通过LSI正下方内置基板去耦削减大约73%的阻抗
通过超薄型薄膜电容器基板内置实现的去耦效果模拟示例如图6所示。
图表中,①为将MLCC在封装背面进行表面贴装,②为将MLCC内置于基板内部,③为超薄型薄膜电容器(TFCP)基本内置+MLCC表面贴装,图表表示各自电气特性的模拟示例。
在①的MLCC表面贴装中,100MHz频带的高频率范围中出现了较大的阻抗峰值。同时,在将MLCC内置于基板内部的②中,虽然高频率范围的阻抗峰值抑制到了一半左右水平,但未得到充分抑制。
而在③的内置超薄型薄膜电容器(TFCP)的封装结构中,高频率范围阻抗降低至了原本水平的约27%。由此可见,之所以能够得到大幅去耦效果,是因为通过将超薄型薄膜电容器配置于LSI正下方,可以缩短电源线与底板间的连接距离,从而实现以往所无法实现的低ESL化。
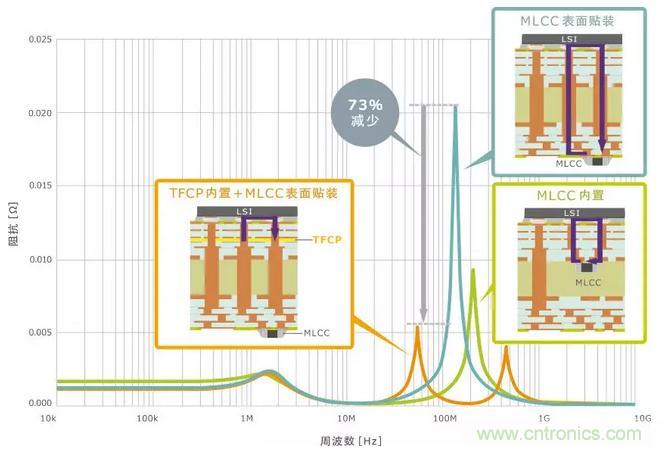
图6:各类封装结构所形成的电气特性的模拟示例
总结
超薄型薄膜电容器(TFCP)是一款独特的片状电容器,它使用了作为TDK核心技术的材料技术,以及HDD磁头制造中所积累的薄膜技术等开发而成。
2016年实现量产后,现在已经开始用于数据中心服务器等高端设备的CPU去耦中。通过配置在LSI正下方封装基板中,不仅实现了小型化及空间节省,同时还实现了高速化、高频率化以及电力节省。为此,其有望在满足IoT时代不断增大的信息量方面做出重大贡献。
TDK的超薄型薄膜电容器(TFCP)为片状结构,因此可通过增加层数来增加静电容量。使静电容量倍增的产品量产技术已经确立,今后将以实现10倍左右的大容量化而进一步推进开展研发工作。
TDK也将通过开发全新电介质材料,深化薄膜形成技术,不断开发拥有多样特性的片材。



