【导读】全球领先的DRAM制造商SK海力士,计划通过推出第五代高带宽内存(HBM5)中的垂直堆叠3D HBM,重新定义AI内存芯片的竞争格局。
全球领先的DRAM制造商SK海力士,计划通过推出第五代高带宽内存(HBM5)中的垂直堆叠3D HBM,重新定义AI内存芯片的竞争格局。

这家韩国芯片制造商正在积极研究三维HBM的实现方式。
该架构将DRAM芯片直接堆叠在图形处理单元(GPU)上方,而非以传统方式并排放置。
“将DRAM垂直堆叠在GPU上可能会彻底改变游戏规则,”SK海力士封装开发部门负责人、副总裁李康旭在韩国电子信息工程师协会上发表主旨演讲时说道。

他指出,这种架构的突破将显著降低数据传输延迟,同时提升带宽和能效,这些都是对性能要求极高的AI行业的关键指标。
李康旭还公布了公司关于HBM的技术路线图,其中3D HBM的推广将从HBM5开始,但仍需几年的发展。
SK海力士目前在HBM研发领域处于行业领先地位。
其HBM3E芯片已实现量产,HBM4预计将在今年晚些时候推出,HBM4E则计划于2026年上市。
HBM5中可能引入的3D堆叠技术,是公司为在生成式AI所需的内存芯片领域,巩固技术主导地位而制定的长期战略。
随着芯片尺寸进一步缩小的难度不断加大,3D芯片封装技术的竞争也日益激烈。

SK海力士的本土竞争对手三星电子也在积极开发3D芯片封装技术,以缩小与代工龙头台积电的差距。
三星的高级互连技术(SAINT,Samsung Advanced Interconnection Technology)旨在将高性能芯片所需的内存和处理器整合在更小的封装中,包括AI芯片在内。
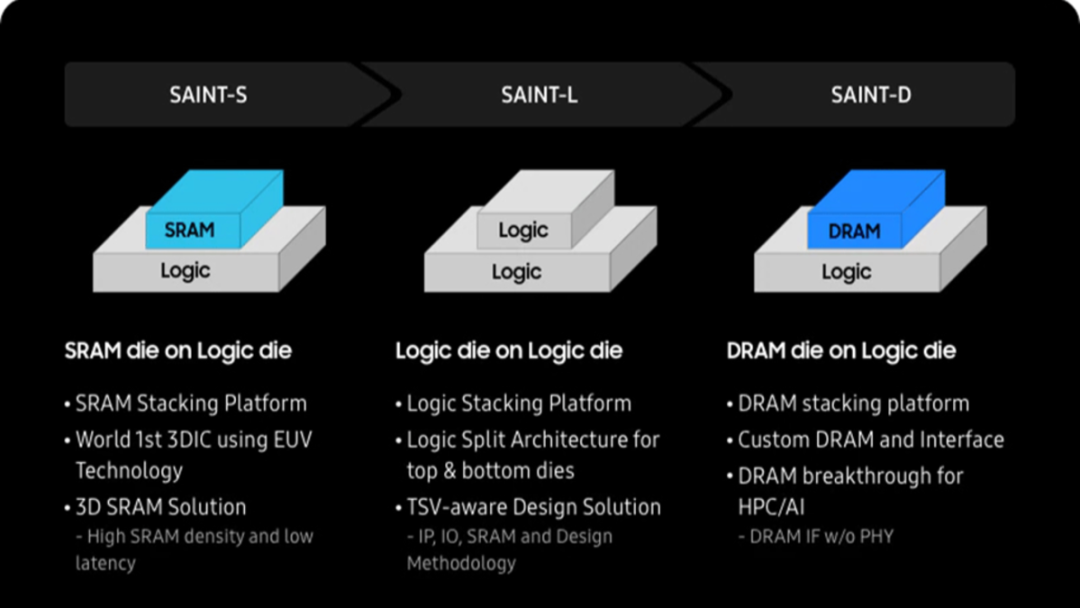
芯片封装是半导体制造的最后环节之一,其作用是在芯片外部包裹保护层以防腐蚀,同时为不同芯片之间的连接提供接口。
包括台积电、三星和英特尔在内的主要芯片制造商正在激烈争夺先进封装技术。
这种技术可以将不同类型的半导体整合,或实现多个芯片的垂直互连,从而使多个芯片组合成为一个完整的电子设备。
先进封装技术能够在不依赖于更精细的纳米制程的情况下提升半导体性能,而后者不仅技术难度高,也需要更长时间开发。
李康旭还表示,SK海力士计划从HBM4E开始引入混合键合技术,该代产品将采用20层DRAM芯片堆叠。
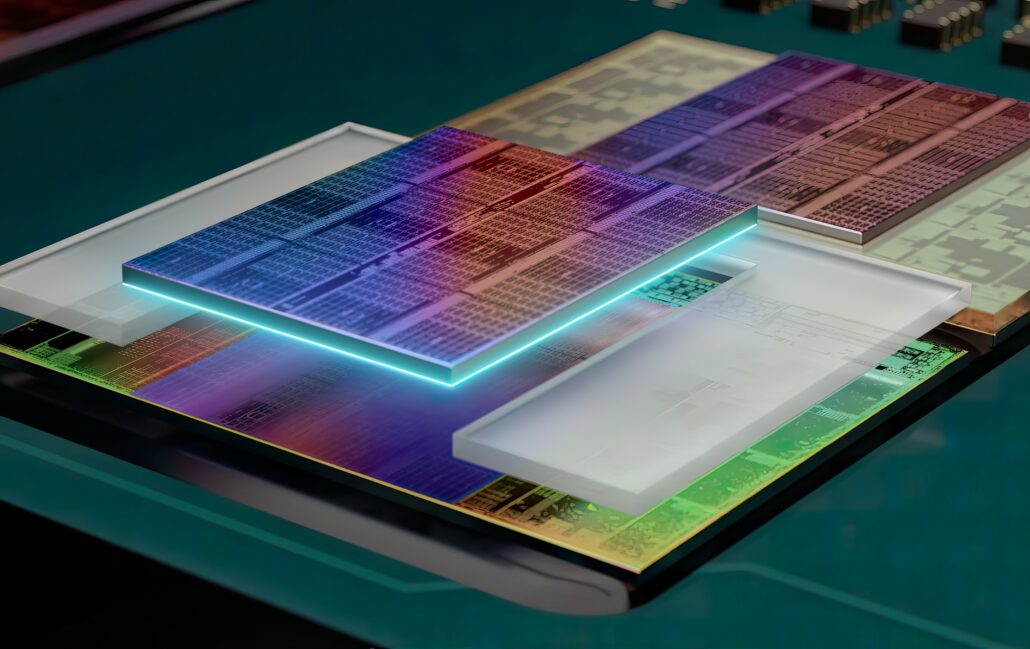
目前为止,公司在最多16层堆叠的第六代HBM(即HBM4)中仍使用MR-MUF技术,该技术通过微凸点连接DRAM层,并利用液体材料填充缝隙。
而从20层堆叠开始,混合键合就变得不可或缺。
混合键合技术通过铜对铜的直接接触连接半导体层,不再需要微凸点,这不仅让芯片更薄,还能提升散热效果。
SK海力士预计,这项新键合技术将在性能和能效方面带来进一步优势。
除了硬件创新之外,SK海力士还在积极推动其先进的2纳米工艺节点,争取客户订单。
其中一家客户是韩国本土AI芯片初创公司DeepX,该公司已成为其2纳米工艺的签约客户之一。

这也标志着SK海力士在韩国AI半导体生态系统中的角色正日益增强。
DeepX专注于嵌入物理安防、机器人、家电、智能出行和智能摄像头等应用场景的AI芯片。
在全球AI芯片供应链竞争日趋激烈的背景下,包括英伟达、台积电、三星以及美光科技在内的行业巨头正争相在内存技术方面争夺性能和规模优势,这对大型语言模型和高性能计算至关重要。
免责声明:本文为转载文章,转载此文目的在于传递更多信息,版权归原作者所有。本文所用视频、图片、文字如涉及作品版权问题,请联系小编进行处理。
推荐阅读:
存储芯片价格腰斩冲击波!联芸科技Q1惊现2400万亏损 全年盈利警报拉响
中国企业霸榜!全球智能手机ODM市场洗牌:44%份额背后的隐秘战局
狂揽255亿美元!台积电一季度营收暴涨35% AI芯片成最强引擎







